芯片的封装大家都算是了解。那么芯片封装具体都有哪些?每种封装有哪些特征,适用什么情况呢?
下面我们来简单聊一下。
芯片封装是安装半导体集成电路芯片用的外壳,起着安放、固定、密封、保护芯片和增强电热性能的作用,而且还是沟通芯片内部世界与外部电路的桥梁——芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印制板上的导线与其他器件建立连接。
最早的芯片封装应该是双列直插封装,即DIP封装。
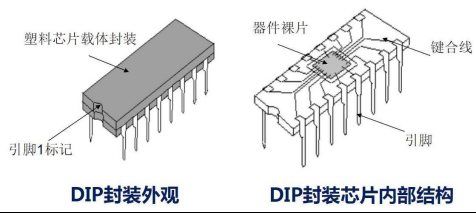
这种封装是插件式,焊接操作很方便,适用于自己手动焊接测试时使用,也适用于一些对空间要求较小的低成本方案里使用。现在产品上使用这种DIP封装的芯片已经很少了。
常用的三极管、MOS管、LDO管的插件封装为TO-220封装,是一种大功率晶体管、中小规模集成电路等常采用的一种直插式的封装形式。

小型化之后变成贴片形式,封装为TO252封装。

SOT223封装。

小一些的三极管封装为TO-92封装,贴片形式有SOT-23-3、SOT-89等封装。

还有一些不常用的插件封装比如早期电机驱动芯片常用的Multiwatt封装。

单列直插封装SIP封装。

还有一种铁帽封装的插件器件,CAN封装或者TO-3、TO-5、TO-8等等。


针对常见的直插封装,还有一些变体,比如引脚数量的变化、增加爬电距离的引脚空位、增加通流能力的引脚连体以及带散热片等形式。


贴片封装首先就是SOP封装,即小外形贴片封装。

随着封装的小型化,SO类型的封装演化除了一系列更小尺寸的封装形式,包括TOSP(薄小外形封装)、SSOP (缩小型SOP)、TSSOP(薄的缩小型SOP)、VSOP(甚小外形封装)、SOIC(小外形集成电路封装)等类似于QFP形式的封装。
SO类的封装只有两边有管脚,该类型的封装是表面贴装型封装之一,引脚从封装两侧引出呈“ L” 字形。该类型封装的典型特点就是在封装芯片的周围做出很多引脚,封装操作方便、可靠性比较高、焊接也比较方便。
现在基本上DIP封装都被SOP封装取代了,焊接也并没有很难,一般芯片都可以选择SOP封装。
常见的SOP封装也有类似DIP封装的一些变体,比如引脚空位、引脚连体、带散热片等形式。



SO类的封装还有一种不常见的封装形式:SOJ封装。这种封装形式引脚是向里弯折的。

MCU常见的封装形式是QFP封装,即方型扁平式封装技术。

QFP封装技术实现的CPU芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。该技术封装CPU时操作方便,可靠性高;而且其封装外形尺寸较小,寄生参数减小,适合高频应用;该技术主要适合用SMT表面安装技术在PCB上安装布线。
我们用的引脚较多的单片机一般都是这种封装形式。
QFP封装细分的话还有PQFP、LQFP和TQFP,这些封装都有哪些区别呢?
PQFP的含义是Plastic Quad Flat Package,即塑料方形扁平封装,表明了封装所用材料。
那LQFP和TQFP呢?这个是在封装尺寸上有区别的。在引脚中心距上不加区别,而是根据封装本体厚度分为 QFP(2.0mm~3.6mm 厚)、LQFP(1.4mm 厚)和TQFP(1.0mm 厚)三种。
而每一种封装本体厚度都可以对应不同的引脚间距,主要有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm 等规格。
至于这几个封装能否通用,简单来说就是,QFP,LQFP,TQFP都是方形扁平封装,在厚度上(QFP>LQFP>TQFP),LQFP和TQFP的PCB封装是可以通用的,前提是bodysize或引脚间距相同。而QFP就不能和这两种通用了。
还有一种封装叫QFN封装,一般功率型器件用的较多,会设计一个较大的地平面,利于散热。

QFN是一种无引线四方扁平封装,是具有外设终端垫以及一个用于机械和热量完整性暴露的芯片垫的无铅封装。在芯片底部大多数会设计一块较大的地平面,对于功率型IC,该平面会很好的解决散热问题,通过PCB的铜皮设计,可以将热量更快的传导出去,该封装可为正方形或长方形。
一些厂家做的模块,比如蓝牙模块、WiFi模块等等,一般会采用邮票孔封装。

以前做项目是还用过一种贴片型功率二极管SB1045L,封装是TO-277。

还用过一种MOS封装:PFDN3333。

如果是CPU芯片的话,引脚一般都特别多,只在四周布置引脚的话,需要特别大的尺寸,于是CPU芯片的引脚就直接在底部分布。
CPU常用的封装形式有PGA、LGA、BGA三种。
PGA的全称叫做“Pin Grid Array”,或者叫“插针网格阵列封装”。
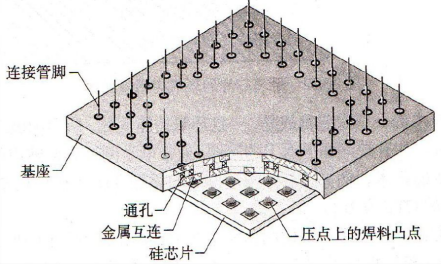
PGA芯片封装形式在芯片的内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列。根据引脚数目的多少,可以围成2-5圈。安装时,将芯片插入专门的PGA插座。为使CPU能够更方便地安装和拆卸,从486芯片开始,出现一种名为ZIF的CPU插座,专门用来满足PGA封装的CPU在安装和拆卸上的要求。
LGA全称是Land Grid Array,直译过来就是栅格阵列封装。说它是“跨越性的技术革命”,主要在于它用金属触点式封装取代了以往的针状插脚。
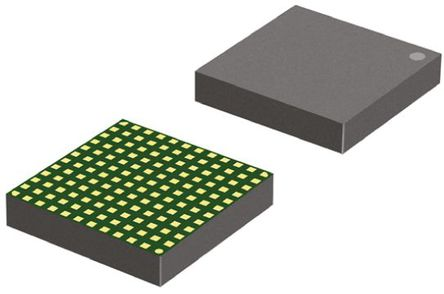
LGA封装为底部方形焊盘,区别于QFN封装,在芯片侧面没有焊点,焊盘均在底部。
BGA的全称叫做“Ball Grid Array”,或者叫“球柵网格阵列封装”。

BGA封装是将电子元件封装在一个多层、由金属和陶瓷组成的球形结构中,以提供更好的热传导性能和更小的封装尺寸。BGA封装可以提供更多的连接点,比普通的插件封装多出几倍,因此可以提供更高的信号完整性和更低的电阻。
三种封装对比的话,严格来说,大家各有胜负,并没有谁最好。
LGA:相比较于PGA而言,体积更小,相比于BGA而言具有更换性。但是对于更换过程中的操作失误要求更严格。
PGA:在三种封装中体积******,但是更换方便,而且更换的操作失误要求低。
BGA:三种封装中体积最小,但是更换可能接近于0,同时由于封装工艺问题,BGA的触点如果在封装过程中没有对准或者结合,极有可能意味着报废,所以相比于LGA,PGA成品率更低。
随着全球电子产品个性化、轻巧化的需求蔚为风潮,封装技术已进步到CSP(Chip Size Package)。它减小了芯片封装外形的尺寸,做到裸芯片尺寸有多大,封装尺寸就有多大。即封装后的IC尺寸边长不大于芯片的1.2倍,IC面积只比晶粒(Die)大不超过1.4倍。
实际上,CSP只是一种封装标准类型,不涉及具体的封装技术,只要达到它的尺寸标准都可称之为CSP封装。而一些封装技术如uBGA、WBGA、TinyBGA、FBGA小型芯片封装技术则是CSP的ui表现形式。CSP没有固定的封装技术,自己更不是一种封装技术,厂商只要有实力,可以开发出更多符合CSP标准的封装技术。
---------------------
|
